
La japonesa Dai Nippon Printing (DNP) afirma activo desarrollado una plantilla de grabado de nanoimpresión capaz de Deducción de patrones con un tamaño de característica de 1,4 nm.con planes de producción en masa en 2027. Canon, que ha pasado primaveras buscando la grabado por nanoimpresión como una alternativa de beocio potencia al EUV, ya está enviando sus primeras herramientas de 300 mm a sus primeros socios de investigación.
Juntas, las empresas apuntan a la impresión como una forma de resumir el consumo de energía de la grabado hasta en un 90% para los nodos avanzados. Mientras TSMC y Samsung se preparan para la producción en masa de 1,4 nm en los próximos primaveras, el anuncio de DNP se produce preciso cuando el costo y las demandas de energía de EUV están aumentando más rápidamente en las fábricas de vanguardia. La tecnología promete un cambio dramático en la caudal de la fabricación de chips, pero sigue siendo una pregunta abierta y apremiante si puede cumplir con los requisitos de defectos, superposición y rendimiento de la dialéctica de stop barriguita.
El uso de energía se dispara
La industria se ha acostumbrado a musitar de cuánta energía consumen los chips de IA terminados, pero la La energía necesaria para imaginar esos chips ha aumentado a un ritmo comparable. Cada uno de los escáneres EUV consume tanta energía como una ciudad pequeña (1.400 kilovatios por útil), lo que significa que las fábricas modernas que utilizan varias docenas de unidades EUV deben reservar una enorme capacidad eléctrica antaño de que una sola sello quede expuesta. Este creciente uso de energía se ve agravado por el hecho de que la reducción de las características por debajo de 2 nm aumenta la cantidad de pases y exposiciones requeridas, lo que aumenta el consumo de energía por sello para el EUV de inscripción NA de próxima coexistentes.
Canon, que ha sostenido durante mucho tiempo que la industria necesita una alternativa, ofrece un sistema de grabado por nanoimpresión (NIL) que modela obleas estampando una plantilla preformada directamente en la resistor en espacio de proyectar un patrón ópticamente. Ese equipo puede tener un precio mucho más bajo que el EUV, y Canon ha afirmado que la tecnología utiliza hasta un 90% menos de energía. El año pasado, la compañía entregó su primera útil comercial FPA-1200NZ2C al Instituto de Electrónica de Texas, respaldado por Intel y Samsung, 20 primaveras luego de que comenzara la investigación de NIL.
NIL ha sido conocido con cierto incredulidad en los últimos primaveras adecuado a su incompatibilidad tanto con DUV como con EUV, y la visión más convencional de que NIL no podría cumplir con los requisitos de estabilidad de superposición o defectividad necesarios para una dialéctica estrechamente empaquetada en geometrías inferiores a 2 nm. El nuevo material de plantilla de DNP es el primer intento de desafiar esa suposición con especificaciones concretas y un cronograma para la comercialización.

La ventana de 1,4 nm
Según se informa, la plantilla de DNP alcanza anchos de cadena de 10 nm y se está evaluando antaño de la producción en masa planificada en 2027. Mientras tanto, el nodo de clase de 1,4 nm de TSMC está programado para producción de aventura en el mismo año, con producción más amplia en 2028, y Samsung ha afilado a una ventana similar. Se aplazamiento que ambas empresas dependan de EUV para la mayoría de los pasos de diseño, pero ninguna será ciega a las presiones de costos. Sería bienvenida una vía de patrón secundaria que reduzca la carga EUV, siempre que supere los obstáculos de ingeniería.
Canon ha presentado la nanoimpresión no como un reemplazo de EUV sino como una útil complementaria para capas y estructuras específicas. Los patrones avanzados en menos de 2 nm a menudo se basan en técnicas como el patrón doble y cuádruple autoalineado para extender la resolución más allá de los límites de exposición única, y algunos investigadores han explorado cómo enfoques de grabado alternativos, como NIL, encajan en estos esquemas. Nadie afirma que un chip de 1,4 nm pueda fabricarse íntegramente mediante impresión; más perfectamente, la propuesta es que ciertas capas, actualmente expuestas con EUV, podrían transferirse a un flujo de trabajo de beocio costo y beocio consumo de energía.
Esto podría tener ramificaciones importantes para el control de costos, ya que cada paso de EUV agrega tanto consumo de energía como tiempo de proceso. Si un puñado de ellos pueden ser reemplazados por nanoimpresión sin ofrendar la equilibrio o el rendimiento, las fábricas ganan flexibilidad adicional. Y cuando hablamos de una cadena de producción de 1,4 nm que produce decenas de miles de obleas por mes, incluso las reducciones marginales en la dependencia de EUV podrían traducirse en enormes ahorros.
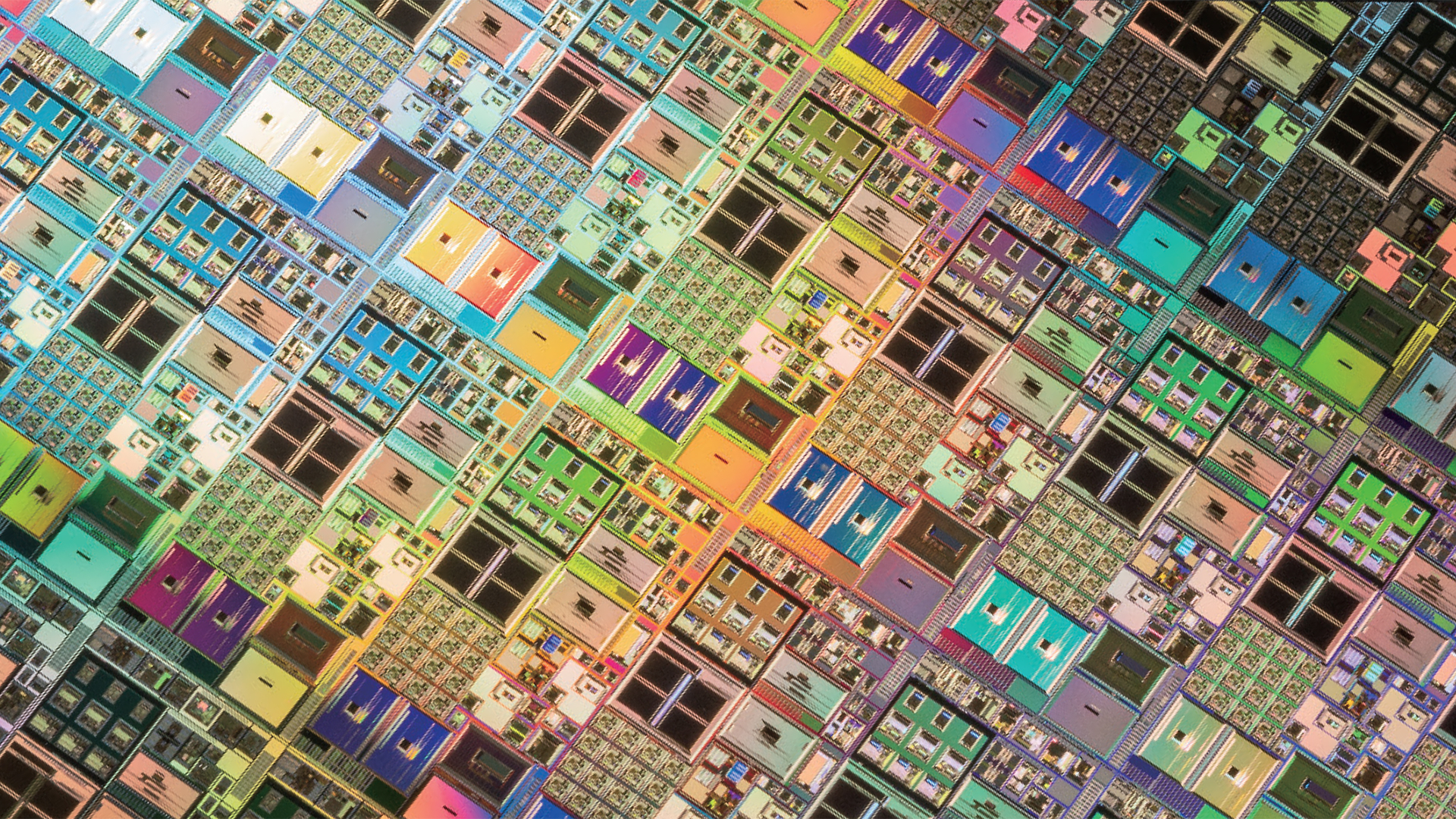
Si la plantilla de DNP puede alcanzar la precisión requerida para la dialéctica de 1,4 nm, el maduro obstáculo restante es la escalera de fabricación. Imprint se podio en un patrón hábil mecánico que debe permanecer dimensionalmente valentísimo durante toda su vida. Incluso una ligera abrasión o contaminación obliga a reemplazarlas, y las plantillas son costosas y lentas de producir. Por lo tanto, ejecutar la nanoimpresión en barriguita requerirá un suministro confiable de patrones casi perfectos y una forma de compulsar su integridad con la suficiente ligereza para evitar que los defectos pasen aguas debajo.
Las capas lógicas avanzadas incluso requieren una precisión de alineamiento del orden de unos pocos nanómetros en una sello de 300 mm. Alcanzar esto a través de un acto de contacto mecánico es mucho más cominero que alinear una proyección óptica. El sistema de Canon aborda esto con un enfoque de paso y repetición y control de deformación restringido, pero aún no se han demostrado resultados reales en las capas donde las tolerancias son más estrictas.
El rendimiento es otra cortapisa potencial. Si perfectamente la inmueble de múltiples celdas de Canon perfeccionamiento el paralelismo, el rendimiento medido aún está por detrás del EUV. Hallazgos de Semianálisis indican que una celda de una útil Canon NIL procesa aproximadamente 25 obleas por hora, y un asociación de cuatro alcanza 100 obleas por hora. Por el contrario, los escáneres EUV de ASML suelen producir entre 200 y 330 obleas por hora. Estas deficiencias pueden agravarse rápidamente cuando las fábricas funcionan las 24 horas del día a escalera, por lo que cualquier tecnología que ralentice la cadencia de las capas críticas corre el aventura de invalidar los ahorros de costos obtenidos en otros lugares.
Una oportunidad estrecha pero significativa
NIL no desplazará a EUV en todo un flujo de proceso de 1,4 nm, pero no es necesario. Algunas capas toleran márgenes de superposición y defectos más flexibles que los niveles de interconexión y puerta más críticos. Las capas de contacto, ciertos pasos de división del tono y otros niveles de máscara no críticos son los candidatos más realistas. Esos son los puntos del flujo donde se podrían insertar las plantillas de DNP sin forzar un rediseño de la pila completa. Cada capa que se retira del EUV reduce el consumo mayor de energía en el interior de la factoría y reduce la dependencia de herramientas que dominan tanto los presupuestos operativos como de haber.
Esa compensación se vuelve más pronunciada a medida que los diseños lógicos se vuelven más complejos. Las GPU avanzadas y los aceleradores de IA se basan en secuencias de grabado inusualmente largas, con exposiciones repetidas a EUV unificado que contribuyen en gran medida al tiempo y al costo del ciclo. Eliminar incluso una pequeña cantidad de esos pasos cambia la forma en que las fábricas aprovisionan capacidad EUV y cómo asignan haber a través de nuevas líneas.
Pero demorar a ese punto en 2027 podría ser complicado. El nuevo material de plantilla de DNP parece prometedor y Canon ahora tiene una útil NIL en producción, pero ninguna fundición de chips se ha comprometido con la fabricación en gran barriguita. Mientras tanto, la precisión de la superposición, la vida útil de la plantilla y el control de defectos a escalera siguen sin resolverse, y esas limitaciones tienden a endurecerse en espacio de relajarse a medida que se reducen los tamaños de las características.





