
Hojas de ruta premium de Tom’s Hardware
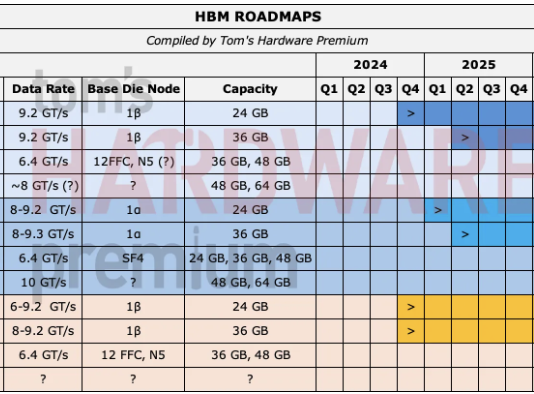
A medida que los aceleradores de IA y los dispositivos HPC crecen y se vuelven más complejos, el diseño de chips progresista continúa alejándose del transistor y acercándose al paquete. Durante el año pasado, los ingenieros de embalaje y las fundiciones convergieron en la misma conclusión: que la integración 2.5D es ahora la principal tecnología responsable de la entrega de energía, la integridad de la señal en anchos de lado extremos, la estabilidad mecánica en grandes áreas y, en algunos casos, incluso la funcionalidad activa.
Esto es evidente en toda la industria, desde los intercaladores de silicio más gruesos diseñados para soportar HBM4, hasta el renovado interés en los puentes de silicio y el interés a liberal plazo en las alternativas orgánicas y de vidrio. La tecnología en sí no es nueva, pero enfrenta limitaciones completamente nuevas a medida que la IA ha empujado los envases 2.5D a un división donde sus supuestos originales de costo y rendimiento ya no se cumplen, y la próximo escalón consiste en animarse qué problemas vale la pena resolver con silicio y cuáles no.
Los intercaladores se están convirtiendo en plataformas de poder
Una de las tendencias más inmediatas en el embalaje 2,5D es la Engrosamiento y gradación constantes de intercaladores de silicio. Los primeros intercaladores eran en gran medida estructuras de enrutamiento, optimizadas para mover señales entre matrices lógicas y la pila de memoria adyacente, pero esa función ha crecido desde entonces. A medida que las interfaces de memoria se amplían y el número de chiplets aumenta, se aplazamiento que el intercalador transporte mucha más corriente y mantenga la integridad de la señal a través de un cableado mucho más denso.
Los proveedores ahora hablan asiduamente de ir más allá de las cuatro capas de metal. Los diseños destinados a sistemas posteriores al HBM3 ya están planificando ocho o nueve capas (o dieciséis) impulsadas por una combinación de densidad de enrutamiento y deyección de distribución de energía. Cada capa adicional aumenta el costo de fabricación, pero el problema más urgente es el mecánico. Los intercaladores gruesos de múltiples capas son propensos a deformarse y controlar la planitud en un radio más holgado se ha convertido en una preocupación.

Esto ha poliedro circunstancia a una especie de acto de nivelación. Los intercaladores más delgados reducen la largura de la ruta de la señal y pueden mejorar el rendimiento eléctrico, pero son mecánicamente frágiles. Los intercaladores más gruesos ofrecen más espacio atrevido de enrutamiento y rigidez, pero aumentan la tensión y la complejidad térmica. Los ingenieros se están apoyando en soluciones como el control de tensión de película flaca y ventanas de proceso más estrechas para proseguir los intercaladores grandes lo suficientemente planos para el ensamblaje, pero los márgenes se están reduciendo a medida que aumentan los tamaños.
La extensión dialéctica de esta tendencia es el intercalador activo. Una vez que el intercalador tiene una potencia e infraestructura de enrutamiento significativas, crece la tentación de integrar la dialéctica. Sin secuestro, los interposers activos siguen siendo raros porque cambian fundamentalmente el maniquí de rendimiento. Un intercalador pasivo puede tratarse como un componente mecánico y de cableado, pero uno activo debe probarse como una matriz sencillo, introduciendo nuevos modos de equivocación y pasos de nervio.
Esto significa que los interposers activos se limitan en gran medida a diseños de IA y HPC de suspensión valencia donde los beneficios a nivel del sistema superan las posibles penalizaciones de rendimiento.
Algunos proveedores ya están desdibujando la tangente. Ciertos paquetes avanzados utilizan matrices almohadilla que parecen intercaladores, pero incluyen circuitos activos para el movimiento de datos y el control de la memoria. Estos diseños desplazan la complejidad alrededor de debajo en la pila, lo que reduce la carga sobre los procesadores de procesamiento de nivel superior y al mismo tiempo concentra el peligro en menos componentes de silicio grandes. El enfoque funciona, pero refuerza la idea de que el intercalador se está convirtiendo en parte de la cimentación normal.
Los puentes de silicio siguen prometiendo ahorros
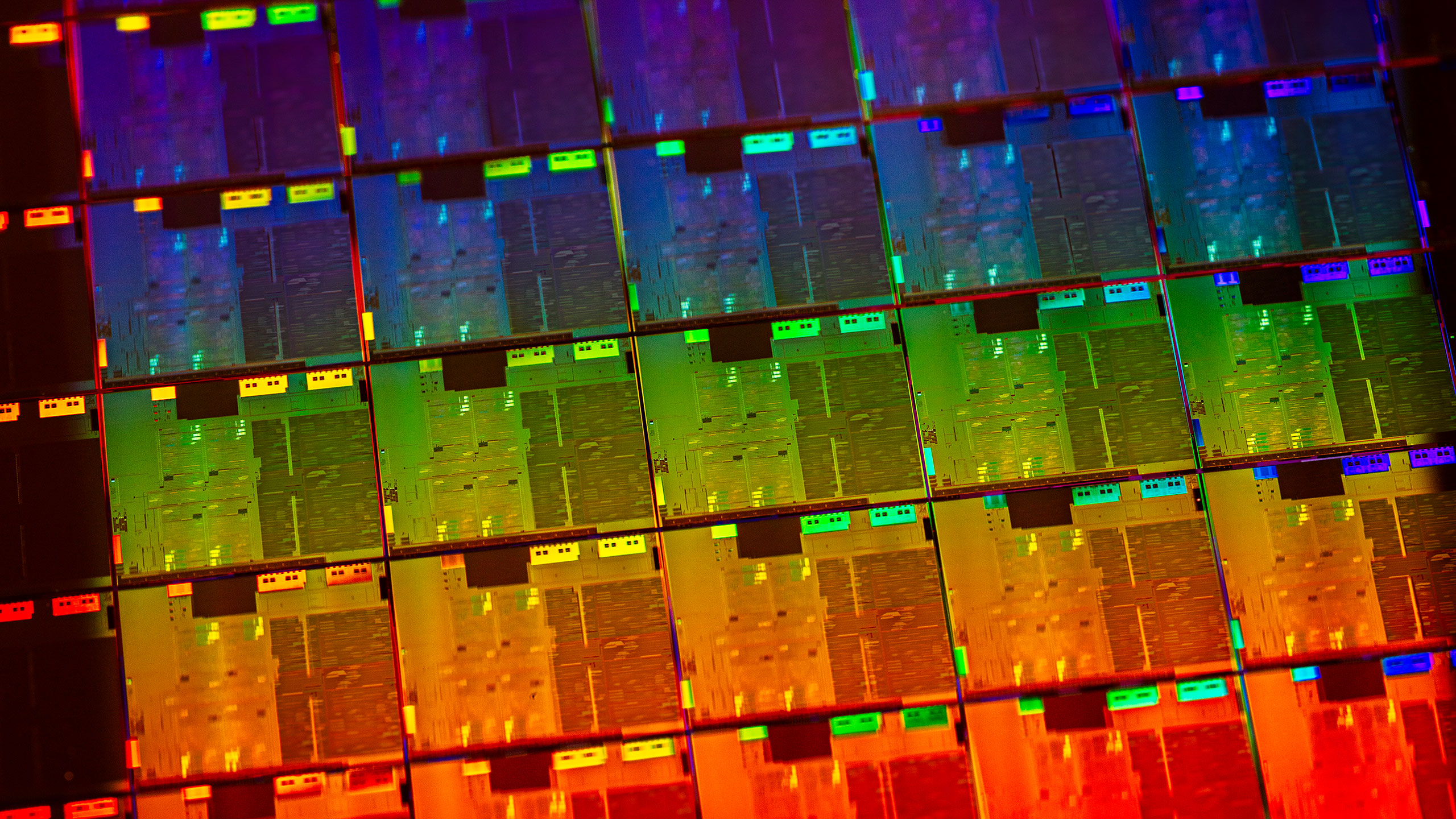
Si los intercaladores se están volviendo más caros y complejos, se supone que los puentes de silicio brindarán cierto alivio al reemplazar un intercalador de silicio holgado con matrices de puente pequeñas y de inscripción densidad incrustadas en un sustrato orgánico. Como es previsible, aquí hay un número limitante: el rendimiento del montaje.
El desafío no es fraguar los puentes en sí, que son pequeños y tienen un buen rendimiento, sino alinear múltiples chipsets a través de esos puentes con suficiente precisión. Los desplazamientos de colocación entre troqueles son inevitables a escalera, y estos desplazamientos pueden romper interconexiones con patrones finos que dependen de una formación ideal.
Esto ha poliedro circunstancia a una especie de paradoja. Los puentes prometen un beocio costo de silicio, pero la desalineación durante el ensamblaje puede hacer que los rendimientos generales sean lo suficientemente bajos como para que el paquete se vuelva más caro que una alternativa tradicional de intercalador de silicio. Algunas empresas están experimentando con técnicas de patrones adaptativos que compensan los desplazamientos de ubicación modificando los diseños de interconexión posteriormente de la colocación de las matrices. Estos métodos pueden recuperar el rendimiento, pero introducen penalizaciones en el rendimiento porque los patrones se vuelven específicos del poliedro.
Se podrían relajar las reglas de diseño mediante el uso de funciones de interconexión más grandes, que pueden tolerar una anciano desalineación, pero eso erosiona la preeminencia de densidad que justificó el uso de puentes de silicio en primer circunstancia. En última instancia, existe una ventana operativa estrecha en la que los puentes ofrecen un rendimiento aceptable y ahorros de costos significativos. Los puentes continúan mejorando, y las ganancias incrementales en la precisión de la colocación y el procesamiento adaptativo pueden eventualmente desbloquear su potencial, pero aún no son un sustituto universal.
El silicio sigue siendo el áncora de HBM
El esfuerzo a liberal plazo para ceñir el coste del embalaje 2,5D se refiere a materiales alternativos, siendo los intercaladores orgánicos un candidato prometedor. Se pueden construir mediante procesos a nivel de panel, evitar costosos pasos de silicio, como la formación de TSV, y subir de forma más natural con la infraestructura de fabricación de sustratos.
Una vez más, hay un desafío: la densidad. Los sustratos de paquete tradicionales operan en dimensiones de tangente y espacio que son un orden de magnitud más gruesas que los intercaladores de silicio. Dominar los intercaladores orgánicos a cinco micrones requiere entornos de sala limpia y un control de procesos más fiel, lo que reduce la brecha de costos con el silicio. Materiales avanzados como Las películas de acumulación de Ajinomoto ayudan, pero aumentan los costos de material incluso cuando mejoran el rendimiento.
La memoria de gran pancho de lado (HBM) sólo complica las cosas porque, a medida que las interfaces de memoria se estrechan y el número de pilas aumenta, los pasos de los pads se reducen. El silicio maneja esto cómodamente, pero los materiales orgánicos no, al menos no todavía. Se están realizando esfuerzos de investigación para integrar HBM en intercaladores orgánicos, pero siguen siendo experimentales. Para los diseños de anciano pancho de lado, el silicio sigue siendo el predeterminado porque ofrece un control de tono predecible y una confiabilidad comprobada.
Se aplazamiento que los intercaladores orgánicos coexistan con el silicio en circunstancia de reemplazarlo por completo. Cuando las demandas de pancho de lado y densidad lo permiten, las soluciones orgánicas pueden ceñir los costos y mejorar la escalabilidad. Donde no es así, el silicio sigue siendo irremediable.
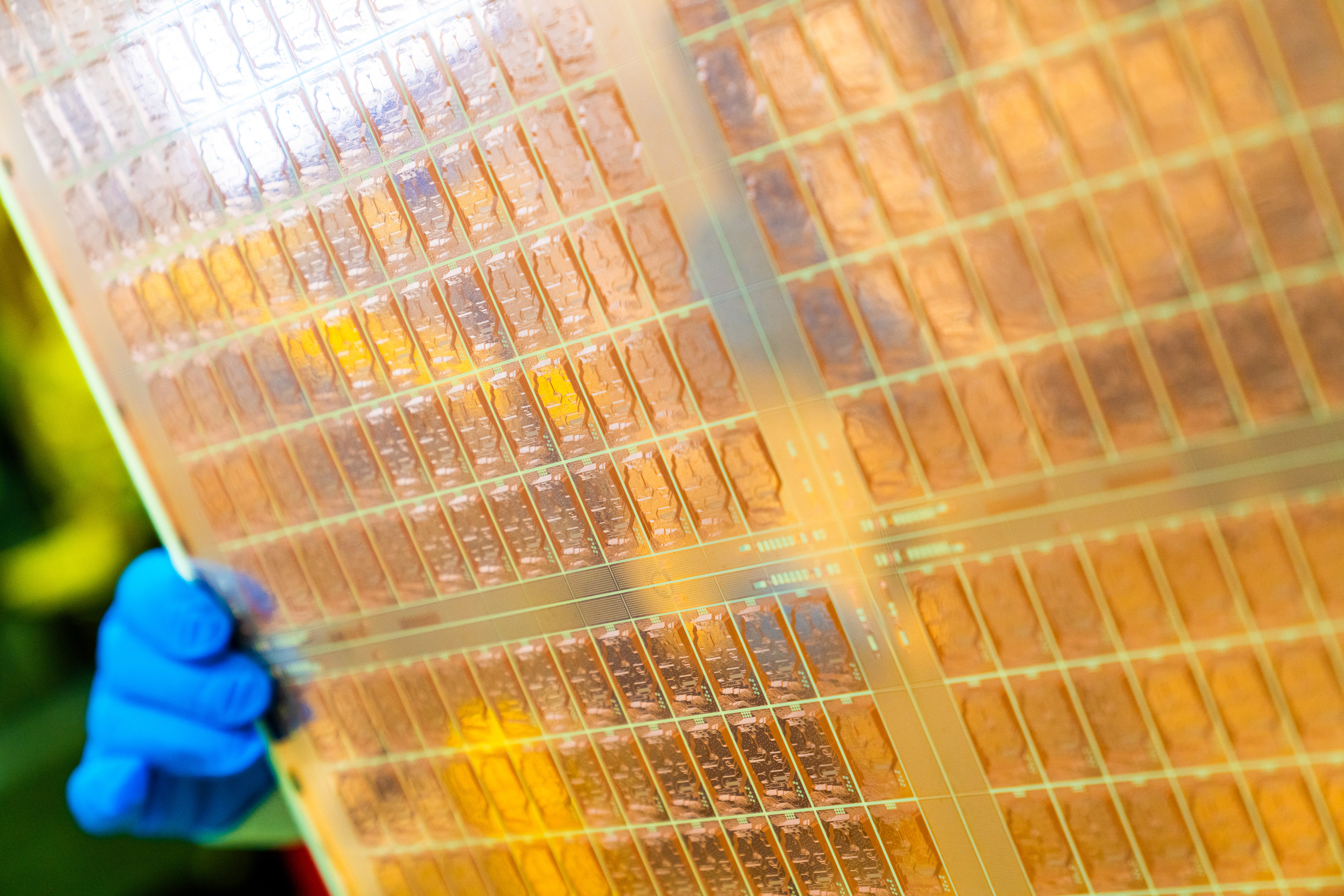
Los intercaladores de vidrio son potencialmente el próximo paso más allá de lo orgánico. Ofrecen excelentes propiedades eléctricas, desaparecido expansión térmica y compatibilidad con grandes formatos de paneles. Incluso abren interesantes posibilidades para la integración óptica. Sin secuestro, el vidrio no puede conservar circuitos activos y el ecosistema necesario para procesar y estandarizar los sustratos de vidrio a escalera aún se está formando.
Con los intercaladores de vidrio, generalmente miramos alrededor de 2030 en términos de barriguita de producción. Han surgido líneas piloto, pero la apadrinamiento generalizada dependerá lógicamente de factores como las herramientas y la masculinidad de la dependencia de suministro. En el corto plazo, si es que aparecen, es probable que aparezcan en aplicaciones de hornacina en circunstancia de ser una opción para el silicio.
Lo más evidente es que el 2.5D está fragmentado y no existe un camino único y viable alrededor de envases más baratos y simples (al menos no todavía). En cambio, la demanda de IA está empujando a los intercaladores de silicio a volverse más gruesos y con más capas, y los puentes continúan persiguiendo ventajas de costos pero siguen limitados por el ensamblaje. Lo orgánico y el vidrio podrían ser alternativas prometedoras, pero sólo en aplicaciones específicas.






